「研磨条件の数値化1」
「半導体パッケージ断面の構造解析」でお困りではありませんか?
新発想の試料研磨機「IS-POLISHER」によるワイヤボンディングの研磨事例をご紹介します。
研磨事例「ボンディングの配列出し」
課題
半導体パッケージ断面の構造解析の場合、ボンディング箇所を配列通りに精度よく露出させることが必要ですが、人によって仕上がりにばらつきがあったり、熟練者であっても削りすぎてしまうという課題があります。
解決策
- 「1軸傾斜ホルダ」は0.01°で傾斜角を調整できるので、ボンディングやバンプの配列を精度よく揃えることが可能
- 「削り過ぎ防止機能」を使用することでミクロン単位の断面研磨を繰り返すことが可能
- 研磨時間、回転数、回転方向、送り速度、荷重、研磨エリア、角度補正、削り量設定などの基本条件を数値化することで、誰もが熟練者の技術と同じ試料作製が可能
研磨プロセス

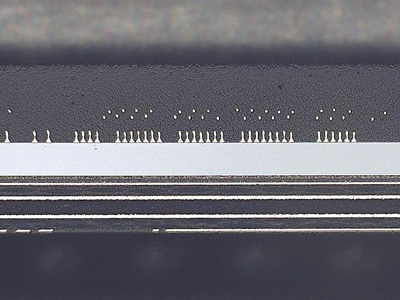


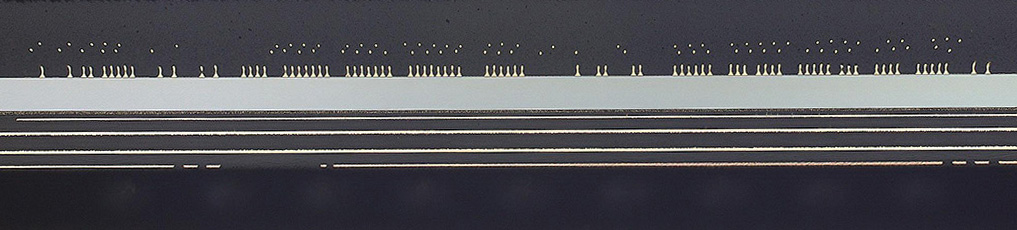
使用機能
詳細はこちら
試料研磨サービスの紹介
お客様の材料や製品の、品質改善や製品開発をサポートする「試料研磨サービス」を行なっています。試料研磨・観察・測定・元素分析を弊社にお任せいただくことで、他の仕事に専念でき、社内の効率化が図れます。






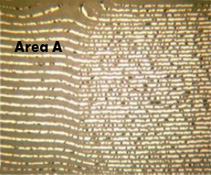

コメントを投稿するにはログインしてください。